N-канальные горизонтально рассеянные полупроводниковые или вертикально рассеянные полупроводниковые транзисторы оксида металла, подходящие для высокого напряжения
Simscape/Электрический/Полупроводники и конвертеры

Блок N-Channel LDMOS FET позволяет моделировать транзисторы LDMOS (или VDMOS), подходящие для высокого напряжения. Модель основана на поверхностном потенциале и включает эффекты из-за области расширенного дрейфа (дрейфа):
Нелинейные емкостные эффекты, сопоставленные с областью дрейфа
Поверхностное рассеяние и насыщение скорости в области дрейфа
Насыщение скорости и модуляция длины канала в области канала
Сохранение заряда внутри модели, поэтому вы можете использовать модель для симуляций, чувствительных к заряду
Внутренний диод тела
Обратное восстановление в модели диода тела
Температурное масштабирование физических параметров
Для теплового варианта (см. «Тепловой порт»), динамического самонагрева
Физическая структура модели показана на следующем рисунке.
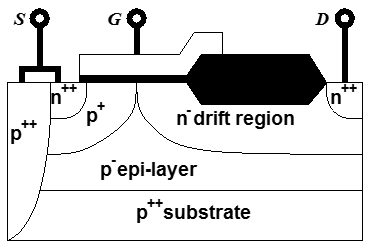
Область канала находится в области p +, от сильно n-легированного источника до конца области p +. Дрейф- область является слегка легированным дренажным удлинителем. Далее вниз имеется эпи-слой p-типа, а затем вся структура находится на сильно легированном p-легированным субстрате. Оксид затвора является тонким по всей области канала и по части области дрейфа. Далее в зону дрейфа оксид затвора имеет большую толщину в области локального окисления кремния (LOCOS).
Следующий рисунок показывает эквивалентную схему модели.
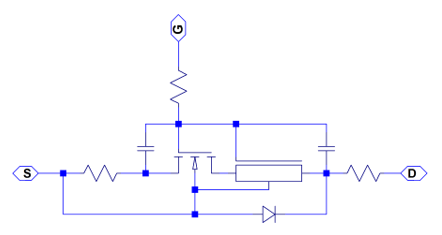
Методы моделирования аналогичны [1]. Перекрытия контакта затвора с истоком и дренажными n-образными скважинами моделируются как кусковые линейные емкости. Область канала (p +) моделируется с помощью модели MOSFET на основе поверхностного потенциала. pn-соединение между источником/навалом и дренажем моделируется с помощью идеального диода, включающего как соединительные, так и диффузионные емкости. Область дрейфа под тонким оксидом затвора моделируется согласно составу с поверхностным потенциалом, который включает:
Ток, обусловленный слоем накопления на границе между полупроводником и оксидом
Ток от электронов, текущих к дренажу, глубже внутри области дрейфа
Пространственная область заряда между эпи-слоем и областью дрейфа представлена с помощью эффекта зажима на ток, протекающий через большую часть области дрейфа. Часть LOCOS области дрейфа моделируется как комко-последовательный резистор, а также существуют последовательные сопротивления, добавленные к контактам источника и затвора.
Для подробного описания модели канала смотрите основанную на поверхностном потенциале модель блока N-Channel MOSFET. Модель области дрейфа аналогично получают из потенциала поверхности, используя уравнение Пуассона. Для полупроводника n-типа под постепенным приближением канала, определяющие уравнения:
где:
ψ - электростатический потенциал.
q - величина электронного заряда.
ND - плотность допинга области дрейфа.
ɛSi - диэлектрическая диэлектрическая проницаемость полупроводникового материала (для примера, кремния).
ϕB - различие между собственным уровнем Ферми и уровнем Ферми в глубокой области дрейфа.
VCB - квазиферми-потенциал области дрейфа, относящейся к массе.
ϕT - тепловое напряжение.
kB Больцмана постоянная.
T - температура.
Если мы пренебрегаем инверсией для модели тока постоянного тока, мы получаем следующее текущее выражение:
где:
ID - ток стока.
θsat - насыщение скорости.
Vij - различие напряжений между узлами i и j, где нижние индексы D и K относятся к дренажу и соединению областей канала и дрейфа, соответственно, а нижний индекс G относится к затвору с коррекции, обусловленной приложением плоского диапазона напряжений.
flin/ RD представляет проводимость большей части области дрейфа, включая эффект защемления из-за истощения от интерфейса эпи-дрейфа.
β - коэффициент усиления слоя накопления на границе раздела между областью дрейфа и оксидом тонкого затвора.
θsurf является параметром, который учитывает рассеяние в слое накопления из-за вертикального электрического поля.
Защемление объемной части области дрейфа описывается как
где:
λD является параметром, представляющим n-стороннюю вертикальную глубину области пространственного заряда вдоль границы раздела эпи-дрейфа при нулевом смещении, разделенном на вертикальную глубину непередаваемой части области дрейфа при нулевом смещении.

На рисунке верхней сплошной линией является полупроводниковая поверхность. Нижняя сплошная линия является соединением между областью дрейфа и слоем эпи. Штриховые линии показывают степень области пространственного заряда вокруг интерфейса дрейф-эпи. λD y1/ y2 при нулевом смещении.
Vbi - встроенное напряжение для диода эпи-дрейфа.
VSB - напряжение источника-тела, используемое в качестве приближения к смещению, приложенному к диоду эпи-дрейфа. Использование этого напряжения вместо VKB является более численно стабильным и оправдано, потому что большая часть напряжения источника стока падает через область дрейфа в состоянии «on-state» транзистора.
Модель заряда подобна модели MOSFET на основе поверхностного потенциала с дополнительными выражениями для расчета заряда в области дрейфа. Блок использует выведенные уравнения, как описано в [1], которые включают и инверсию, и накопление в области дрейфа.
Блок моделирует диод тела как идеальный, экспоненциальный диод с как соединительной, так и диффузионной емкостями:
где:
Idio - ток через диод.
Is - обратный ток насыщения.
VDB - напряжение стока-тела.
n является фактором идеальности.
ϕT - тепловое напряжение.
Cj - соединительная емкость диода.
Cj0 является емкостью перехода с нулевым смещением.
Vbi - это встроенное напряжение.
Cdiff - диффузионная емкость диода.
τ - время транзита.
Емкости определяются посредством явного вычисления зарядов, которые затем дифференцируются, чтобы дать емкостные выражения выше. Блок вычисляет емкостные диодные токи как производные по времени от соответствующих зарядов, аналогичные расчетам в модели MOSFET на основе поверхностного потенциала.
Поведение по умолчанию состоит в том, что зависимость от температуры не моделируется, и устройство моделируется при температуре, для которой вы обеспечиваете параметры блоков. Чтобы смоделировать зависимость от температуры во время симуляции, выберите Model temperature dependence для параметра Parameterization на вкладке Temperature Dependence.
Модель включает температурные эффекты на емкостные характеристики, а также моделирование зависимости статического поведения транзистора от температуры во время симуляции.
Параметр Measurement temperature на вкладке Main задает температуру Tm1 при которой были извлечены другие параметры устройства. Параметры Temperature Dependence обеспечивают температуру симуляции, Ts и коэффициенты масштабирования температуры для других параметров устройства. Для получения дополнительной информации см. «Температурная зависимость».
Блок имеет дополнительный тепловой порт, скрытый по умолчанию. Чтобы открыть тепловой порт, щелкните правой кнопкой мыши блок в модели, а затем из контекстного меню выберите Simscape > Block choices > Show thermal port. Это действие отображает тепловой порт, H на значке блока, и отображает параметры Thermal Port.
Используйте тепловой порт, чтобы симулировать эффекты сгенерированного тепла и температуры устройства. Для получения дополнительной информации об использовании тепловых портов и о параметрах Thermal Port, смотрите Симуляция Термальных эффектов в Полупроводниках.
Тепловой вариант блока включает динамическое самонагревание, то есть позволяет моделировать эффект самонагрева на электрические характеристики устройства.
[1] Aarts, A., N. D'Halleweyn, and R. Van Langevelde. Модель транзистора LDMOS на основе поверхностного потенциала и высокого напряжения. Транзакции IEEE на электронных устройствах. 52(5):999 - 1007. Июнь 2005 года.
[2] Van Langevelde, R., A. J. Scholten, and D. B. M. Klaassen. "Физический фон MOS Model 11. Уровень 1101 ". Туземный. Лаборатория. Неклассифицированный доклад 2003/00239. Апрель 2003 года.
[3] О, S-Y., Д. Э. Уорд и Р. У. Даттон. «Переходный анализ МОП транзисторов». Твердотельные схемы IEEE J. SC-15, стр. 636-643, 1980.